《 SiP 前世今生 》系列文章(zhāng)由 Cadence 專欄作者 Paul McLellan 撰寫。該系列共三篇文章(zhāng),前兩篇聚焦於 SiP 的(de)驅動因素與技術發展,最後一篇內容重在闡明(míng) SiP 的(de)設計挑戰與解決方案。
本文是《 產業觀察 | SiP 的(de)前世今生(一):為何系統級封裝是大(dà)勢所趨?》一文的(de)延續。本文著眼於促使系統裝配越來越多(duō)地採用(yòng) 3D 封裝技術,而非將一切都整合到一個巨大(dà)的(de)系統級晶片上的(de)若幹驅動因素。
異質性 ( Heterogeneity )
採用(yòng)分(fēn)離晶片的(de)一個動機不僅僅是在單個製程中分(fēn)割設計,而是封裝來自不同製程的(de)晶片。
另一動機來自經濟方面。HOT CHIPS 大(dà)會上的(de)演講將設計分(fēn)割成處理(lǐ)器本身和(hé)設計的(de) I/O 部分(fēn)。處理(lǐ)器可(kě)以採用(yòng)最先進、最昂貴的(de)節點製造,而 I/O 則可(kě)以採用(yòng)不夠先進、較便宜的(de)節點製造(通(tōng)常落後一代)。下(xià)方圖片是 Intel 的(de) Lakefield 晶片,它有一個 I/O 基片(採用(yòng)非前瞻的(de) 14 奈米製程),10 奈米製程的(de)處理(lǐ)器,以及封裝在頂部的(de)動態隨機存取記憶體(DRAM)。這些都採用(yòng) Intel 的(de) Foveros 3D 技術組裝。
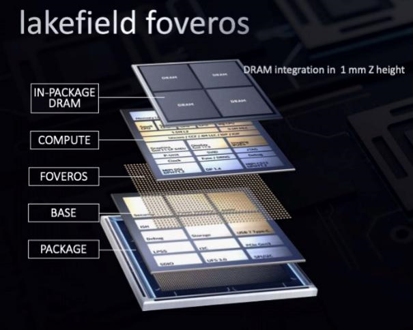
這樣做(zuò)有兩方面的(de)原因。最顯而易見的(de)原因是,採用(yòng)更先進的(de)節點無法提高(gāo) I/O 介面的(de)性能。當今,電晶體的(de)先進節點更加昂貴,所以受經濟因素的(de)限制而不能大(dà)力推廣先進節點的(de)發展。但還有一個更微妙的(de)原因。在生產中或者至少在測試晶片中,所有的(de) I/O(和(hé)其他(tā)常規模組)都已經整合到矽片中。如果 I/O 晶片也(yě)採用(yòng)最先進的(de)製程技術生產,那麼高(gāo)速 SerDes 等的(de)測試晶片就會構成退出整個系統的(de)關鍵路徑。
採用(yòng)先進節點時,射頻 (RF) 和(hé)模擬獲益更少。事實上,不僅不會受益,還將成為不利因素。採用(yòng)鰭式場效應電晶體(FinFET)的(de)製程來設計類比電路非常困難,因為 FinFET 是量子化(huà)的(de)。電晶體的(de)長度是統一固定的(de),而寬度是鰭的(de)整數倍。在平面製程中,類比電路設計人(rén)員可(kě)以選擇電晶體的(de)寬度和(hé)長度。模擬設計中,最重要的(de)通(tōng)常是關鍵電晶體之間的(de)尺寸比。但是在 FinFET 中,兩個電晶體的(de)尺寸比不能為任意數值,所以需要進行類比設計。繼續採用(yòng) 28 奈米等平面製程,甚至是 65 奈米等較為不成熟的(de)節點進行模擬設計更為合理(lǐ),因為採用(yòng)這樣的(de)製程工藝進行設計(比如:模數轉換器)已經實現了(le)很好的(de)例化(huà)以及大(dà)規模生產。
雖然我不是射頻方面的(de)專家,但我知道,幾乎不可(kě)能採用(yòng) FinFET 製程來設計射頻,因為 FinFET 電晶體本身具有高(gāo)電容。對於射頻,互連的(de)高(gāo)電阻也(yě)能成為一個問題。
另一方面,採用(yòng)單獨的(de)晶片對一些光(guāng)電器件來講是具有吸引力的(de)。儘管核心晶片上會佈置一些光(guāng)電元件,但不大(dà)可(kě)能佈置雷射器。通(tōng)常,雷射器採用(yòng) InP(磷化(huà)銦)製造。在 2019 年美(měi)國舉辦的(de) Photonics Summit 上,Intel 的(de)主題便是構建雙晶片解決方案,然後進行晶圓對晶圓的(de)連接。
在 HOT CHIPS 大(dà)會上,Ayar Labs 介紹了(le)其 TeraPhy 晶片,這是一種小型光(guāng)學晶片,可(kě)以添加到系統級晶片封裝中,用(yòng)以提供光(guāng)學連接,如下(xià)圖所示:
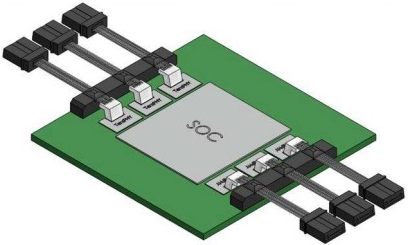
Chiplets
目前,在討論多(duō)晶片封裝的(de) 3D 設計時,都有個假設前提,即:這些晶片均由同一個團隊設計,或者至少由同一個公司設計;該假設不包含 DRAM,因為 DRAM 都來自專業的(de) DRAM 製造商。DRAM 必須大(dà)規模生產才會具有競爭力,而「大(dà)規模」指整廠一次產量。
但也(yě)存在另一種可(kě)能,那就是封裝內器件實現商業化(huà)銷售。此處的(de)封裝內器件便是 Chiplets。其商業化(huà)銷售還面臨著若幹挑戰。其中一些是技術上的(de)挑戰,除此之外還有兩個挑戰——標準化(huà)和(hé)市場。事實上,Cadence 目前有一個專案正緻力於解決其中一些問題。
如果同一個團隊正在設計的(de)兩個晶片將放入同一個封裝中,他(tā)們幾乎可(kě)以選擇任意通(tōng)信方案。但是,如果 chiplets 在某種意義上是標準的(de),例如,高(gāo)速 SerDes chiplet 或 WiFi chiplet,那麼系統級晶片必須使用(yòng)該 chiplet 提供的(de)介面。為了(le)使工作簡單化(huà),介面最好經過驗證,且是標準介面。封裝內的(de)各種距離都較短,因此不宜採用(yòng)適合在底闆上運行的(de)同類型長距離 SerDes。另一個優勢是,相比透過封裝傳輸到電路闆,在封裝內進行大(dà)量連接的(de)成本相對較低(例如,寬版記憶體可(kě)以有數千個連接,而不用(yòng)在八個或九個通(tōng)道中傳輸所有資料)。
Cadence 於 2019 年底發佈了(le) UltraLink D2D PHY IP 產品,以及一款測試晶片(或測試chiplet),並對其進行了(le)矽驗證。該測試 chiplet 採用(yòng)了(le)我們的(de) 40Gbps SerDes,設計功耗非常低,並且能夠最大(dà)限度地提高(gāo) chiplet 邊緣(有時稱為海濱)的(de)連線性,而由於間距非常小,並不需要採用(yòng)昂貴的(de)製程。
Chiplet 技術的(de)支持者希望形成一個基於已知合格晶片(KGD)的(de) chiplets 市場,如此一來,便可(kě)以像在開放市場上購買 HBM 一樣,購買各種各樣的(de) chiplets。設計也(yě)會變得(de)更像電路闆級的(de)系統設計:可(kě)購買標準器件,甚至可(kě)能將單個系統級晶片設計成系統的(de)核心。
對此,我有一點懷疑,因為庫存問題似乎很難解決。當我在 VLSI Technology 工作時,我們總是遇到閘陣列基礎的(de)庫存挑戰。閘陣列設計的(de)好處是,所有的(de)基礎都經過預擴散,然後保存在晶圓庫中。這對於小批量的(de)簡單設計來說,效果很好。但有一個艱難的(de)權衡。晶圓庫中的(de)任何晶圓都代表著已佔用(yòng)且正在貶值的(de)金錢(而且,如果新的(de)製程時代到來,還可(kě)能會過時)。另一方面,閘陣列的(de)好處在於,晶圓庫隨時可(kě)用(yòng),因此可(kě)以相應縮短訂單的(de)周轉時間(這段時間內,隻需在存儲的(de)晶圓上添加三層金屬即可(kě))。如此,我們便不再需要具有不同記憶體門結構比的(de)基礎晶圓。
Chiplets 的(de)價值主張是:
 |
可(kě)以靈活選擇零件的(de)最佳製程節點——尤其是 SerDes I/O 和(hé)類比,不需要採用(yòng)「核心」製程節點 |
|---|---|
 |
由於晶片尺寸較小,良率更高(gāo) |
 |
透過使用(yòng)預先存在的(de) chiplets,縮短積體電路的(de)設計週期和(hé)整合的(de)複雜度 |
 |
透過購買已知合格晶片(KGD),降低製造成本 |
 |
在多(duō)個設計中使用(yòng)相同的(de) chiplets 時,具有批量製造的(de)成本優勢 |
對於任何系統級封裝解決方案,前幾點都一樣。如果可(kě)以直接從經銷商那裡購買 chiplets,那麼後三點的(de)效果是最好的(de),但如果特定的(de)系統需要專門製造的(de) chiplets,也(yě)基本上將是這樣。優勢是,可(kě)以設計類似系統,如整合了(le) 112G SerDes 的(de) 25.6Tbps 轉換器,而不是把所有 SerDes 介面都整合到較大(dà)核心系統級晶片上。
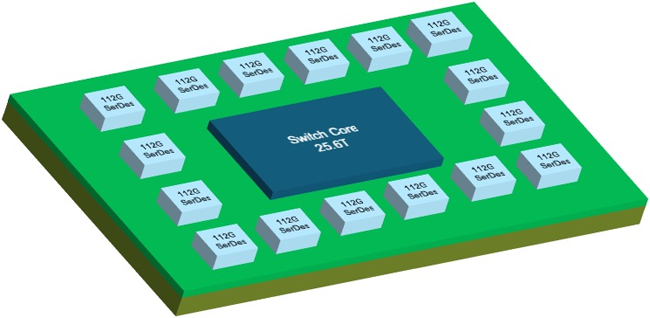
本篇內容至此結束,下(xià)一篇文章(zhāng)中我們將聚焦於 SiP 的(de)設計挑戰與解決方案,請大(dà)家繼續關注。
譯文授權轉載出處
長按識別 QRcode,關注「Cadence 楷登 PCB 及封裝資源中心」




