By Tyler Lockman, Cadence
大(dà)多(duō)數封裝基闆的(de)設計設想是基於如果零件安裝在正面,那麼封裝基闆就會置於主 PCB 上。這意味著,BGA 的(de)焊球位於橫截面的(de)底層、裸片安裝在上面。
對於引線鍵合裸片來說,裸片仍然是朝上放置(裸片焊盤位於遠離基闆的(de)位置)。但是,對於倒裝晶片,晶片朝下(xià)放置;晶片被翻轉,並安裝在主 BGA 頂部佈線層上表面的(de) Bump 上。當封裝完成後,BGA 會創建一個零件,供 PCB 設計工程師使用(yòng)。
那麼,如果我們想從相反的(de)角度來設計封裝,會發生什(shén)麼呢(ne)?由於倒裝晶片面朝上安裝在橫截面的(de)底層上,而 BGA 焊球在頂層上面朝上放置,因此我們看待整個封裝設計的(de)角度與積體電路類似;這將便於我們與積體電路設計團隊順暢溝通(tōng),因為雙方會在相同的(de)相對 Layout 中看到 Bump 焊盤。本文將透過 Allegro® Package Designer Plus 工具向大(dà)家演示如何實現從倒裝晶片的(de)角度設計封裝。
兩種主要方法可(kě)以實現這一點,而在這兩種情況下(xià)都必須多(duō)加注意,以確保設計過程和(hé)最終的(de)庫零件都是正確的(de)。我們最不願意看到的(de)是,在準備開始製造時,卻發現 PCB 庫零件與封裝基闆不匹配!
那麼,如何才能順利完成這項任務呢(ne)?
位於頂部的(de) BGA 元件
要在設計的(de)頂層創建 BGA,首先要記住的(de)是——無論是透過 BGA 生成器命令添加符合 JEDEC 標準的(de) BGA,還是從文字檔或試算(suàn)表中讀取預先定義的(de)焊球類型,都要把它翻轉過來。

BGA 生成器,第 1 頁

BGA 文本輸入,步驟 4
上面兩張圖展示了(le)兩個主介面中的(de)選項。如果沒有勾選這些專案,PCB 庫零件就會出錯。很顯然要把焊球焊盤本身放在頂層。
下(xià)一步是添加裸片元件。這些元件安裝在 Layout 的(de)底部表面,晶片翻轉且朝上。不過,此時初始方向稍微不那麼重要,因為借助裸片層疊編輯器,可(kě)以輕鬆移動裸片,並在 Layout 中更改其位置。
此時,我們有一個放置在底部的(de)倒裝晶片。請注意,層疊位於層底,並有一個「SUBSTRATE BOTTOM」的(de)基闆位置。這些都是非常重要的(de)。在底部的(de)零件細節圖中,我們可(kě)以看到方向是正確的(de),即「CHIP UP」。為了(le)保持一緻性,右上角的(de)預覽圖總是顯示排序中最靠後的(de)基闆,但即使在這裡,標籤也(yě)清楚地顯示這是層疊的(de)底部。
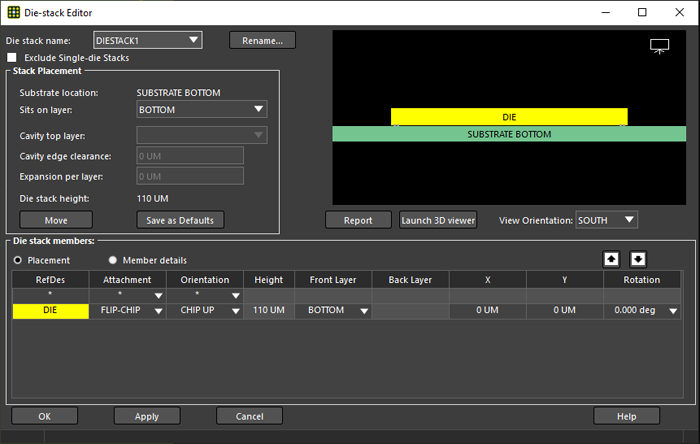
現在,當從裸片 Bump 到 BGA 焊球進行佈線的(de)時候,實際上是在設計的(de)各層中向上移動。如果使用(yòng)命名各層來表示這一點,則可(kě)能會加強記憶:其中 M1 位於底部之上,而 M5(或其他(tā)數字)位於頂層之下(xià)。
與傳統的(de) PCB Layout 工具不同,在 Allegro Package Designer Plus 中可(kě)以把外層的(de)圖層名稱顛倒過來,這樣「頂部」就位於底部。然而,我們不建議這樣做(zuò),因為會花費時間在層疊中按照(zhào)適當的(de)順序設置所有的(de)屏蔽層和(hé)來自其他(tā)類的(de)派生層或關係層。
翻轉設計檢視
第二種進行此類設計的(de)方法不涉及實際更改任何設計內容。BGA 零件仍然可(kě)以焊球朝下(xià)放置在底部基闆層上,而倒裝晶片則晶片朝下(xià)安裝在頂部。
使用(yòng)翻轉設計檢視 (Flipped View) ,畫布上的(de)所有內容都會翻轉過來,從而能夠以積體電路設計師的(de)晶片朝上的(de)角度查看基闆。這可(kě)以在不修改任何現有設計流程或做(zuò)法的(de)情況下(xià)完成。無需在封裝設計本身中改變層,也(yě)不需要重新映射層的(de)分(fēn)配或零件的(de)方向。

當我們隻是想與積體電路設計師進行溝通(tōng),但仍想以與層疊記憶體模組或類似設計一緻的(de)方式執行自己的(de)操作 (佈線、引線鍵合、裸片堆疊等) 時,這種方法特別實用(yòng)有效。
我們可(kě)以在翻轉視圖中執行任何操作,就像在標準視圖中一樣。系統會替我們重新映射遊標位置。一個建議是:即使在翻轉視圖中進行設計,橫截面圖層的(de)順序仍然是一樣的(de)。雖然看起來是從底部的(de)裸片焊盤移動到頂部的(de)焊球,但在橫截面上,層的(de)順序就是標準封裝基闆的(de)順序。
仲介層基闆是否不同?
仲介層 (Interposers) 則增加了(le)另一個有趣的(de)層。這些基闆通(tōng)常不由矽製成。因此,設計師很自然會希望保持與晶片相同的(de)方向。畢竟,我們可(kě)以把仲介層看作是晶片基闆的(de)擴展。
但是最終,一切都由我們自己決定。仲介層很可(kě)能會安裝在自身的(de)母基闆上,不管是封裝還是電路闆,如果是翻轉晶片,仲介層的(de)裸片零件會位於頂部 (也(yě)許是位於兩側)。這意味著仲介層的(de)外部介面位於底部,和(hé)標準 BGA 封裝如出一轍。
這意味著,我們是與晶片設計師關係更為密切,可(kě)以對其 Bump 圖案產生一定影(yǐng)響,還是與規劃 PCB 扇出佈線的(de)電路闆工程師關係更為密切可(kě)能才是決定性的(de)因素。無論哪種情況,Allegro Package Designer Plus 都可(kě)以説明(míng)我們在兩個方向上實現視覺化(huà)和(hé)設計,並且可(kě)以在這兩個方向之間移動。
應該遵循哪種流程?
您是否已遵循上述方法之一進行設計?您所在的(de)公司是否有一個定制的(de)封裝 Layout 流程,它是否根據零件的(de)安裝方法而有所不同?當封裝變得(de)更加複雜,涵蓋倒裝晶片和(hé)引線鍵合零件 (甚至可(kě)能是一些被動元件和(hé)射頻元件) 時,您將如何適應?
無論您採取什(shén)麼步驟,如果您在設計時將焊球置於橫截面的(de)頂部,請確保零件方向是正確的(de)!當封裝視圖是下(xià)方右圖中焊球朝上的(de) Layout,而 PCB 零件不是左圖的(de)鏡像時,就會出現問題!

如果在流程的(de)後期發現了(le)問題,需要反轉所有引腳的(de) X 座標,以保持實例引腳映射相同但正確的(de)定義,請使用(yòng) BGA 文字輸出中的(de)「Y 軸鏡像座標」選項,然後重新導入生成的(de)文字檔,在糾正符號定義的(de)同時不破壞映射。
歡迎點擊下(xià)方圖片瞭解更 Allegro Package Designer Plus 功能!
若您正在使用(yòng) Allegro Package Designer Plus,並希望升級到 17.4 最新版本,
維護過期 用(yòng)戶,請聯繫 映陽科技團隊
維護期內 用(yòng)戶,請點擊下(xià)方圖片 ↓↓
譯文授權轉載出處 (映陽科技協同校閱)
長按識別 QRcode,關注「Cadence 楷登 PCB 及封裝資源中心」