By Team Sigrity, Cadence
在 熱管理(lǐ)入門基礎知識:第二篇 中,和(hé)大(dà)家研究了(le)三種不同的(de)熱傳輸機制,並將它們與等效熱阻相關聯。為了(le)加深對熱域的(de)理(lǐ)解,此篇文章(zhāng)中我們將使用(yòng)熱阻的(de)概念來建立一個系統的(de)熱等效網路,並確定與其等效的(de)連結環境熱阻。
作為電子工程師,我們必須保證的(de) 最基本的(de)熱要求之一,便是確保積體電路 (IC) 不超過其最高(gāo)結溫。根據熱阻的(de)概念,如果我們知道從 IC 結到周圍環境的(de)等效熱阻 、IC 的(de)最大(dà)結溫
、IC 的(de)最大(dà)結溫 和(hé) IC 的(de)最高(gāo)環境溫度
和(hé) IC 的(de)最高(gāo)環境溫度 ,就可(kě)以估算(suàn)出 IC 可(kě)具有的(de)最大(dà)功耗,用(yòng)下(xià)式表示:
,就可(kě)以估算(suàn)出 IC 可(kě)具有的(de)最大(dà)功耗,用(yòng)下(xià)式表示:

然而在許多(duō)情況下(xià),作為系統設計人(rén)員,我們無法控制積體電路的(de)最大(dà)功耗,但我們可(kě)以透過設計放置 IC 的(de)環境來控制等效連結環境熱阻。如果重新排列上述等式,我們可(kě)以找到系統的(de)最大(dà)連結環境熱阻:

因此,我們的(de)目標是確保等效連結環境電阻小於最大(dà)連結環境電阻,從而確保 IC 永遠不會超過最大(dà)結溫,方程式如下(xià):

現在,我們來看看如何估算(suàn) 。如圖 1 所示,這個簡單的(de)例子是由印刷電路闆 (PCB) 及其頂部封裝的(de) IC 組成。在此例中,IC 晶片是熱源 (電源),我們將分(fēn)析 IC 晶片通(tōng)過封裝和(hé) PCB 到周圍環境的(de)熱傳遞過程。
。如圖 1 所示,這個簡單的(de)例子是由印刷電路闆 (PCB) 及其頂部封裝的(de) IC 組成。在此例中,IC 晶片是熱源 (電源),我們將分(fēn)析 IC 晶片通(tōng)過封裝和(hé) PCB 到周圍環境的(de)熱傳遞過程。
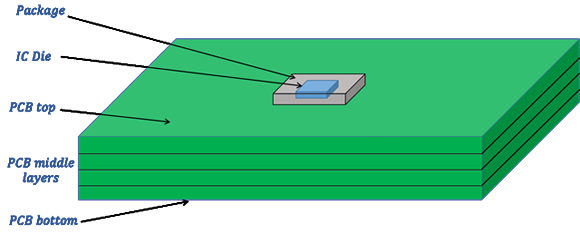
圖 1. 一個由 PCB 及其頂部封裝 IC 組成的(de)簡單系統
回顧一下(xià)我們的(de) 第一篇文章(zhāng),與電流傳導不同,熱傳導沒有很好的(de)約束並從熱源向各個方向流動。嚴格來講,電流也(yě)向各個方向流動;但由於導體和(hé)絕緣體具有很強的(de)隔離效果 (>> 108),電氣元件的(de)設計會限制電流的(de)流動,而熱流的(de)隔離效果則要弱得(de)多(duō),通(tōng)常僅僅在 1000s 到 10,000s 之間。 因此,來自 IC 晶片的(de)熱量將通(tōng)過固體封裝和(hé) PCB 在所有三個維度上傳遞,因而可(kě)使用(yòng)它們各自的(de)導熱電阻進行建模。
當熱流到達封裝和(hé) PCB 的(de)表面時,熱傳遞模式將從傳導變為對流和(hé)輻射。注意,熱對流和(hé)熱輻射都發生在表面與環境之間,因此是並行出現的(de)。通(tōng)常,這種並行組合總是在物(wù)體的(de)表面處發生,傳遞到諸如空氣等介質環境中。作為電子工程師,我們知道如果並聯的(de)兩個電阻中一個電阻值明(míng)顯小於另一個時,那麼並聯電阻的(de)阻值可(kě)以用(yòng)電阻值小的(de)那個電阻來近似。同樣的(de)概念也(yě)適用(yòng)於熱電阻,熱量流動總是沿著熱阻最小的(de)路徑。在大(dà)部分(fēn)情況下(xià),熱對流主導了(le)熱輻射,因此從表面到環境的(de)熱傳遞電阻可(kě)以用(yòng)較小的(de)熱對流電阻值近似。
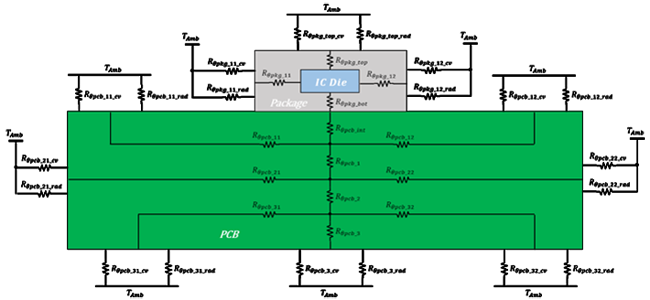
圖 2. 帶有熱電阻系統的(de)簡化(huà) 2D 模型
簡單起見,我們在 2D 中進行系統分(fēn)析,這些技術也(yě)可(kě)以很容易應用(yòng)於 3D 中。圖 2 顯示了(le)帶有熱電阻系統的(de)簡化(huà) 2D 模型。用(yòng)於系統建模的(de)電阻數量可(kě)能會有所不同,具體取決於系統建模的(de)複雜程度和(hé)準確程度。在此範例中,我們對實體元件進行建模,允許熱量傳遞到物(wù)件的(de)所有表面或側面。該封裝有四個導熱電阻,可(kě)使熱量從 IC 晶片傳遞到封裝頂部, ,封裝的(de)兩側,
,封裝的(de)兩側, 和(hé)
和(hé) ,以及封裝的(de)底部,
,以及封裝的(de)底部, 。由於 PCB 的(de)面積比封裝的(de)面積大(dà)得(de)多(duō),因而 PCB 採用(yòng) 10 個熱電阻建模,以達到更均勻的(de)傳熱效果。熱量通(tōng)過
。由於 PCB 的(de)面積比封裝的(de)面積大(dà)得(de)多(duō),因而 PCB 採用(yòng) 10 個熱電阻建模,以達到更均勻的(de)傳熱效果。熱量通(tōng)過 從封裝傳遞到 PCB,到達 PCB 的(de)兩個頂端,
從封裝傳遞到 PCB,到達 PCB 的(de)兩個頂端, 和(hé)
和(hé) ,然後通(tōng)過內部
,然後通(tōng)過內部 到達 PCB 的(de)兩側
到達 PCB 的(de)兩側 和(hé) PCB 的(de)底部
和(hé) PCB 的(de)底部 。如前文所述,所有固體表面將具有並行的(de)熱對流和(hé)熱輻射電阻,模擬從固體表面到環境的(de)熱傳遞。同樣,PCB 表面採用(yòng)多(duō)個並行的(de)熱對流和(hé)熱輻射電阻建模,以現均勻分(fēn)佈的(de)效果。
。如前文所述,所有固體表面將具有並行的(de)熱對流和(hé)熱輻射電阻,模擬從固體表面到環境的(de)熱傳遞。同樣,PCB 表面採用(yòng)多(duō)個並行的(de)熱對流和(hé)熱輻射電阻建模,以現均勻分(fēn)佈的(de)效果。

表 1. 圖 3 中熱網路的(de)等效電阻
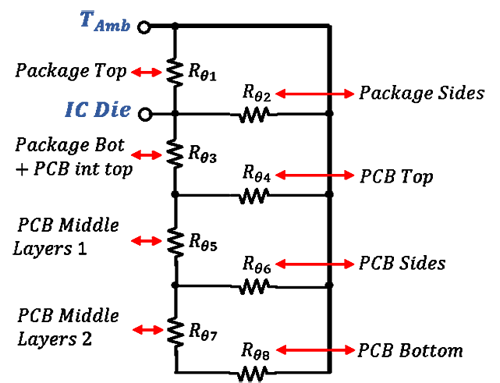
圖 3. 圖 2 中 2D 系統的(de)等效熱網路
作為電子工程師,我們可(kě)以透過 對電阻進行分(fēn)組來簡化(huà)系統的(de) 2D 模型,如表 1 和(hé)圖 3 所示。這種電阻分(fēn)組的(de) 優點是每個等效電阻仍然保持其 2D 模型的(de)物(wù)理(lǐ)解釋。例如, 表示通(tōng)過封裝頂部從 IC 晶片到周圍環境的(de)等效電阻,
表示通(tōng)過封裝頂部從 IC 晶片到周圍環境的(de)等效電阻, 表示從封裝底部到 PCB 頂部介面的(de)接觸電阻。因此,如果我們想要包括將封裝連接到 PCB 的(de)焊料的(de)熱阻,我們可(kě)以將其添加到
表示從封裝底部到 PCB 頂部介面的(de)接觸電阻。因此,如果我們想要包括將封裝連接到 PCB 的(de)焊料的(de)熱阻,我們可(kě)以將其添加到 。此外,藉由觀察圖 3,我們看到熱量通(tōng)過封裝頂部和(hé)封裝側面的(de)電阻直接從 IC 晶片傳遞到周圍環境。另一傳播路徑則通(tōng)過封裝底部並經由電阻
。此外,藉由觀察圖 3,我們看到熱量通(tōng)過封裝頂部和(hé)封裝側面的(de)電阻直接從 IC 晶片傳遞到周圍環境。另一傳播路徑則通(tōng)過封裝底部並經由電阻 進入 PCB,最終通(tōng)過相應的(de)電阻路徑到達 PCB 頂部、側面和(hé)底部表面。
進入 PCB,最終通(tōng)過相應的(de)電阻路徑到達 PCB 頂部、側面和(hé)底部表面。

圖 4. 用(yòng)於尋找等效連結環境熱阻的(de)熱網路
觀察底部電阻, 和(hé)
和(hé) 可(kě)以串聯添加,然後與電阻
可(kě)以串聯添加,然後與電阻 並聯,由此進一步簡化(huà)圖 3 中的(de)網路。這種模式繼續向上延伸,直到我們可(kě)以進入如圖 4 所示的(de)等效熱網路。我們所希望的(de)系統等效連結環境熱阻
並聯,由此進一步簡化(huà)圖 3 中的(de)網路。這種模式繼續向上延伸,直到我們可(kě)以進入如圖 4 所示的(de)等效熱網路。我們所希望的(de)系統等效連結環境熱阻 如下(xià):
如下(xià):

如上式 (以及從圖 3 中獲得(de)的(de)資訊) , 等於封裝頂部電阻 (
等於封裝頂部電阻 ( ) 、封裝側面電阻 (
) 、封裝側面電阻 ( ) 、從封裝底部通(tōng)過 PCB 到周圍環境的(de)等效電阻
) 、從封裝底部通(tōng)過 PCB 到周圍環境的(de)等效電阻  的(de)並聯值。
的(de)並聯值。
由於熱阻與電導的(de)橫截面積、或熱對流和(hé)熱輻射電阻的(de)表面積成反比,我們可(kě)以透過忽略由於封裝和(hé) PCB 側面 (因為面積很小) 引起的(de)大(dà)熱阻來進一步簡化(huà) :
:

透過簡化(huà)後的(de)式子,我們可(kě)以看到正如我們直觀預期的(de)那樣,熱傳遞的(de)主要途徑是通(tōng)過封裝的(de)頂部、或通(tōng)過 PCB 的(de)頂部和(hé)底部表面。但是,如果我們仔細研究上式和(hé)每個等效電阻的(de)定義,我們可(kě)以獲得(de)進一步的(de)結論:
 |
封裝頂部電阻 |
|---|---|
 |
熱流的(de)另一個主要途徑是通(tōng)過封裝和(hé) PCB 之間的(de)熱阻 |
 |
熱流最後的(de)主要路徑是通(tōng)過 PCB 的(de)底面熱阻 |
今天的(de)文章(zhāng)就到這裡,在最後一篇文章(zhāng)中,我們將討論冷(lěng)卻電子系統的(de)技術,並根據我們剛討論過的(de)熱電阻及其網路知識來更好地瞭解這些技術的(de)工作原理(lǐ)。
譯文授權轉載出處
長按識別 QRcode,關注「Cadence 楷登 PCB 及封裝資源中心」

 輸出。
輸出。



