By Team Sigrity, Cadence
如今愈來愈多(duō)的(de)封裝 / PCB 系統設計需要進行熱分(fēn)析。功耗是封裝 / PCB 系統設計中的(de)關鍵問題,需要仔細考慮熱和(hé)電兩個領域的(de)問題。為了(le)更好地理(lǐ)解熱分(fēn)析,我們以固體中的(de)熱傳導為例,並利用(yòng)兩個領域的(de)對偶性。
圖 1 和(hé)表 1 描述了(le)電域與熱域之間的(de)基本關係。
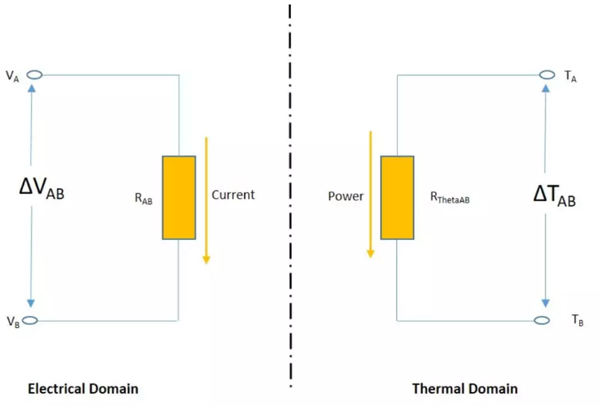
圖1:電域與熱域之間的(de)基本關係

表1:電域與熱域之間的(de)基本關係
電域與熱域之間存在一些差異,比如:
 |
在電域,電流被限制在特定電路元件內流動,但在熱域中,熱流通(tōng)過三種熱傳導機制(傳導、對流和(hé)輻射)在三維空間從熱源散發出去。 |
|---|---|
 |
元件之間的(de)熱耦合比電耦合更加明(míng)顯且難以分(fēn)離。 |
 |
測量工具不同。對於熱分(fēn)析,紅外熱像儀和(hé)熱電偶取代了(le)示波器和(hé)電壓探頭。 |
當固體或靜止流體介質中存在溫度梯度時發生熱傳導。 熱對流和(hé)熱輻射是比熱傳導更複雜的(de)熱傳輸機制。 熱對流發生在固體表面與不同溫度流體材料接觸時,熱輻射來自於所有溫度大(dà)於絕對零度的(de)物(wù)質的(de)電磁輻射。 圖 2 顯示了(le)三種熱傳輸工作圖,所有上述熱傳輸機制的(de)一維應用(yòng)的(de)描述性等式如表2 所示。
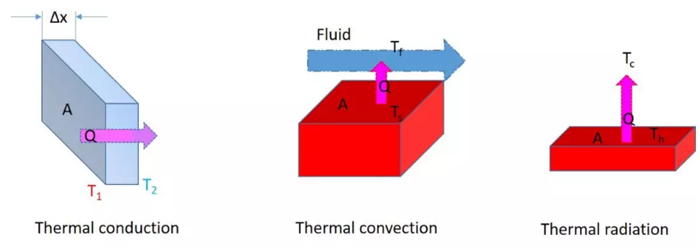
圖2:三種熱傳輸機制

表2:不同熱傳輸模式的(de)方程式
其中:
 |
Q 為每秒傳輸的(de)熱量 (J/s) |
|---|---|
 |
k 為導熱係數 (W/(K.m)) |
 |
A 為物(wù)體的(de)截面積 (m²) |
 |
ΔT 為溫差 |
 |
Δx 為材料厚度 |
 |
hc 為對流傳熱係數 |
 |
hr 為輻射傳熱係數 |
 |
T1 為一側的(de)初始溫度 |
 |
T2 為另一側的(de)溫度 |
 |
Ts 為固體表面的(de)溫度 (℃) |
 |
Tf 流體的(de)平均溫度 (℃) |
 |
Th 為熱端溫度 (K) |
 |
Tc 為冷(lěng)端溫度 (K) |
 |
ε 為物(wù)體的(de)輻射係數(對於黑(hēi)體)(0~1) |
 |
σ 為 Stefan-Boltzmann 常數 =5.6703*10- 8 (W/(m2K4)) |
Sigrity™ PowerDC™ 是一種經過驗證的(de)電熱技術,多(duō)年來一直應用(yòng)於設計、分(fēn)析及驗收封裝和(hé) PCB。整合的(de)電 / 熱協同模擬功能可(kě)幫助用(yòng)戶輕鬆確認設計是否符合指定的(de)電壓和(hé)溫度閾值,而無需花費大(dà)量精力從很多(duō)難以判斷的(de)影(yǐng)響因素中進行篩選。借助這項技術,您可(kě)以獲得(de)準確的(de)設計餘量並降低設計的(de)製造成本。下(xià)圖展示了(le)PowerDC 用(yòng)於電 / 熱協同模擬的(de)方法:

圖3:PowerDC 電 / 熱協同模擬方案
除了(le)電 / 熱協同模擬,PowerDC 還提供了(le)其他(tā)與熱相關的(de)功能,比如:
 |
熱模型提取 (圖4) |
|---|---|
 |
熱應力分(fēn)析 (圖5) |
 |
多(duō)闆分(fēn)析 (圖6) |
 |
晶片 - 封裝 - 電路闆協同模擬 (圖7) |
借助這些技術和(hé)功能,您可(kě)以方便快(kuài)捷地透過圖示、量化(huà)來評估封裝或印刷電路闆設計的(de)熱流及熱輻射。

圖4:封裝熱模型提取
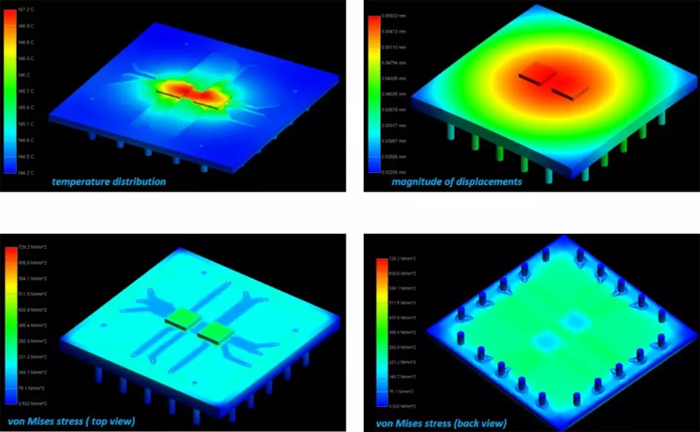
圖5:封裝熱應力分(fēn)析示例

圖6:多(duō)闆熱分(fēn)析
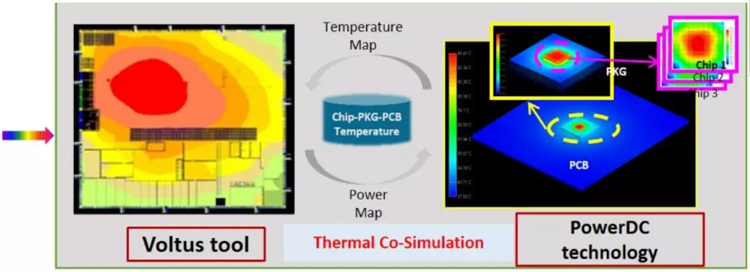
圖7:使用(yòng) Voltus-PowerDC 進行晶片 - 封裝的(de)熱協同模擬



