
如今,半導體封裝行業蓄勢待發,將在未來的(de)電子產品設計中發揮更重要的(de)作用(yòng)。
為了(le)滿足市場對這些異構的(de)、基於晶粒的(de)架構的(de)需求,需要採用(yòng)新的(de)系統級設計方法,並以改善系統級的(de)功率、性能和(hé)面積 (PPA) 為目標。
儘管如今的(de)設計正在使用(yòng)多(duō)晶粒技術,但大(dà)多(duō)數基於晶粒的(de)設計是在垂直整合的(de)公司開發的(de),這些公司既設計晶粒,又設計模組化(huà)或分(fēn)解 SoC。而 Cadence 一直緻力於與諸多(duō)領先的(de)代工廠和(hé)外包的(de)半導體組裝和(hé)測試公司 (OSAT) 合作,開發多(duō)晶片 (晶粒) 封裝參考流程和(hé)封裝組裝設計套件。
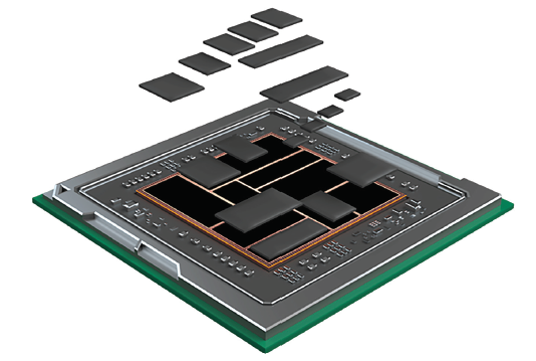
本書為 PDF 版本,共 5 頁,將解析何為晶粒和(hé)異構封裝,以及其如何改變系統設計與分(fēn)析的(de)生態。
本書重點
 |
引言 |
|---|---|
 |
晶粒和(hé)異構整合 |
 |
未來何去何從? |
 |
晶粒 / 小晶片的(de)演變 |
 |
異構整合工具和(hé)流程 |
 |
結論 |
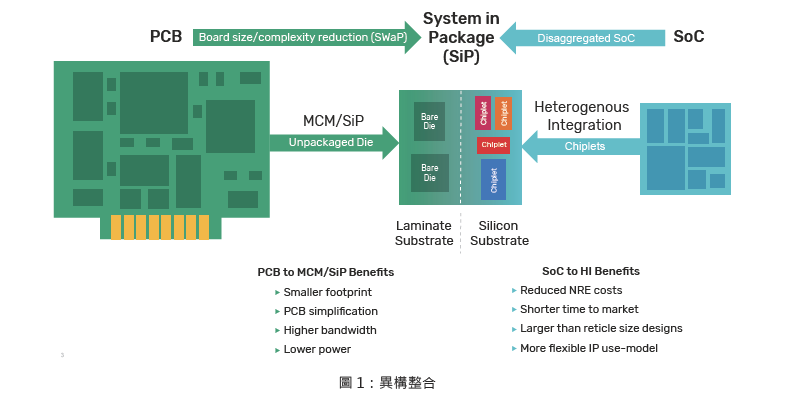
中文版授權轉載出處 (映陽科技協同校閱)
長按識別 QRcode,關注「Cadence 楷登 PCB 及封裝資源中心」





