By Cadence
在 2021 的(de) IMAPS (International Microelectronics Assembly and Packaging Society,國際微電子組裝與封裝學會) 大(dà)會上,Cadence 資深半導體封裝管理(lǐ)總監 John Park 發表了(le)關於 封裝組裝設計套件 (Package Assembly Design Kits,簡稱 ADK) 的(de)演講:什(shén)麼是 ADK,以及 ADK 能為封裝設計帶來哪些好處?
由於異質整合對不同的(de)人(rén)來說意義各不相同,John 首先介紹了(le)該市場的(de)發展歷史和(hé)趨勢:幾十年來,我們一直在從事多(duō) 晶片模組 (Multi-Chip Module,簡稱 MCM) 和(hé)類似的(de)整合工作;但在過去五年左右的(de)時間裡,該領域更加專注於 系統級晶片 (System on Chip,簡稱 SoC) 整合——不同於將所有元件都放在一個大(dà)晶片上,當前的(de)焦點在於製造更小的(de)晶片,通(tōng)常稱為「chiplet」,並把它們整合在某種先進封裝中。
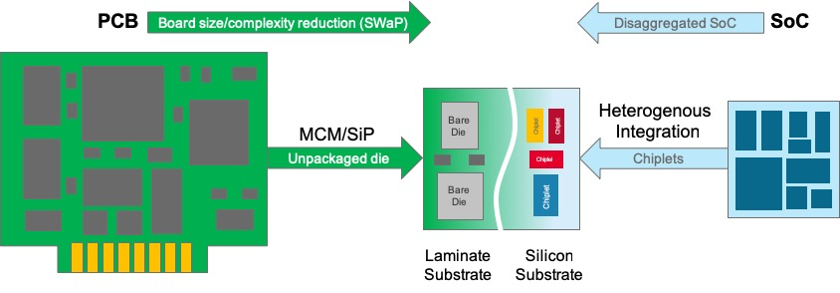
這種方法有很多(duō)優點,具體取決於設計的(de)細節,其中包括:
 |
降低 NRE (Non-recurring engineering Expense,一次性工程費用(yòng)) 成本 |
|---|---|
 |
加快(kuài)產品上市 |
 |
實現比標線尺寸更大(dà)的(de)設計 |
 |
更靈活的(de)架構 (多(duō)進程) |
PDKs
在 20 世紀 90 年代初創建 PDK (Process Design Kits,制程設計套件) 之前,設計規則檔和(hé)用(yòng)於電路模擬的(de) SPICE deck 幾乎充當了(le)晶圓廠和(hé)設計師之間的(de)介面。隨著工藝變得(de)越來越複雜,設計規則的(de)複雜性也(yě)在不斷增加,因此上述做(zuò)法無法再滿足要求。PDK 的(de)理(lǐ)念是,把 IC 設計者需要知道的(de)關於製造過程的(de)一切知識打包起來,以實現成功設計。PDK 可(kě)以被現代 EDA 工具流程所讀取,因此實際的(de) DRC deck 取代了(le)過去的(de)印刷版 DRC 手冊。

針對封裝設計師的(de)類似 PDK 的(de)解決方案
當設計變得(de)越來越難,需要考慮的(de)方面就越來越多(duō)。這導緻封裝設計團隊需要考慮的(de)設計方面日益增長:
 |
先進多(duō)晶片 (多(duō) chiplet) 、基於矽的(de)封裝需要專門的(de)版圖特徵和(hé)形式化(huà)的(de)物(wù)理(lǐ) / 邏輯驗證能力 |
|---|---|
 |
加特定於矽 (矽) 基闆設計的(de)版圖特徵快(kuài)產品上市 |
- 高(gāo)級淚滴補強和(hé)走線加寬 |
|
- 漸進式鋪銅和(hé)透氧孔的(de)演算(suàn)法 |
|
- 大(dà)容量設計支援 |
|
 |
來自封裝設計的(de)光(guāng)罩級精確輸出資料 (GDSII) |
- 高(gāo)級圓弧向量化(huà) |
|
 |
與 IC 實體驗證工具無縫整合,並提供與封裝設計工具間的(de)回饋 |
- 光(guāng)罩級 DRC |
|
- 多(duō)晶片 (多(duō) chiplet) 設計的(de)連通(tōng)性驗證 (電路與佈局驗證) |
|
- 特定區域的(de)高(gāo)級金屬填充 (平衡) |

如果想讓封裝設計師在設計中停止猜測,就需要 ADK 封裝組裝設計套件,其工作方式類似於 PDK。但是,一個複雜的(de)問題是,封裝設計師對所有這些矽問題都很陌生,而 IC 設計師對封裝也(yě)很陌生。那麼,ADK 中會有哪些內容呢(ne)?

上表列出了(le) John Park 認為應該放在 ADK 中的(de)組件。讓我們分(fēn)別深入瞭解一下(xià):
技術檔組件:
 |
這些應該是文字檔,以便於讀取、寫入、比較和(hé)共用(yòng) |
|---|---|
 |
基闆堆疊物(wù)理(lǐ)和(hé)電氣細節 |
 |
信號的(de)物(wù)理(lǐ) / 間距約束 |
 |
信號的(de)電氣約束 |
 |
約束分(fēn)組 |
 |
組裝 / 放置規則 |
 |
測試規則 |

設計庫和(hé)模型元件:
 |
Footprints |
|---|---|
- JEDEC 標準 BGA / LGA 和(hé) SMD |
|
- 焊盤 |
|
- STEP 檔 (真正的(de) 3D 渲染) |
|
 |
3D 鍵合線文件 |
- 基於鍵合設備的(de)模型 |
|
- 3D DRC 所需 |
|
 |
I/O 模型 |
- 行為 (IBIS) |
|
- 電晶體級 |
|
 |
熱 / 功耗模型 |
- 晶片 (小晶片) 級熱和(hé)功耗模型 |
|
- 靜態和(hé)暫態功耗資訊 |
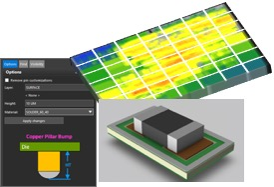
組裝設計組件:
 |
GUI 圖形式介面,簡化(huà)設置 |
|---|---|
 |
設備獨有的(de) DFA 概要 |
 |
設計同步、直接回饋元件的(de)放置和(hé)移動情況 |
 |
表格驅動、帶使用(yòng)者定義的(de)元件類別 |
 |
基本模式 (表格) 和(hé)高(gāo)級模式 (約束管理(lǐ)器) |
 |
規則定義的(de)設置可(kě)以在庫級的(de)單獨工具中完成 |

用(yòng)於驗證 chiplet 到 chiplet 互連的(de)合規性測試包組件:
 |
基於與 PCB 類似的(de)合規經驗 |
|---|---|
 |
抖動容限 |
 |
插入損耗 |
 |
回波損耗 |
 |
眼圖範本 (用(yòng)於 SerDes) |

規則檢查 (矽仲介層) 元件:
 |
設計規則檢查 |
|---|---|
- 包括 3D 堆疊引腳對齊 |
|
 |
電路與佈局驗證 |
- 晶片到晶片 (chiplet 到 chiplet) |
|
- 系統級 |
|
 |
金屬填充 |
- 智慧金屬平衡 |
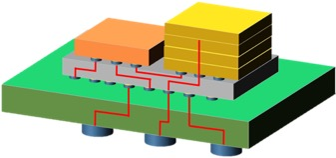
抓住機遇,引領市場
對於應當立刻採用(yòng) ADK 的(de)原因,John Park 表示:
 |
數十年來,PDK 在 IC 設計界已經得(de)到成功採用(yòng) |
|---|---|
 |
封裝技術的(de)複雜性呈爆炸式增長,不應該在資訊不充分(fēn)的(de)情況下(xià)盲目設計 |
 |
IC 設計師和(hé)封裝設計師都面臨新的(de)挑戰,需要新的(de)方法 |
 |
封裝設計界應該開始採用(yòng) ADK 了(le) |
譯文授權轉載出處 (映陽科技協同校閱)
長按識別 QRcode,關注「Cadence 楷登 PCB 及封裝資源中心」




